图1所示的是GA-SBD在不同参数下的BV曲线。在相同的阳极金属功函数条件下,MFP越深则BV越大。在相同的MFP深度下,阳极金属功函数越高器件BV越大。而随着MFP深度的减小,这种BV差距也在增大。这说明MFP的钳位作用逐渐消失,而BV值与阳极金属公函数关系更大。除了阳极功函数为4eV,同时r>10nm的两个样品。其他几个仿真样品的BV值均大于200V。就目前所报道的实验以及仿真结果来看,这对于只有3μm漂移区长度的器件来说,已经属于较高的反向阻断性能。
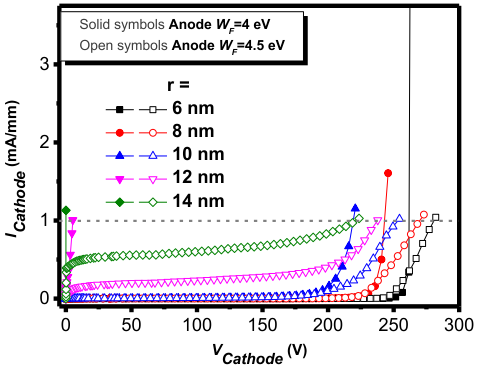
图1 不同的r与不同WF下GA-SBD的BV
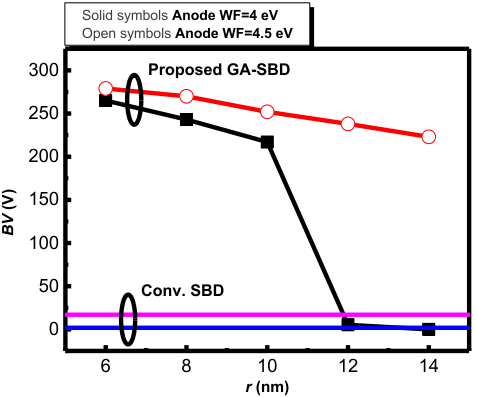
图2 GA-SBD与传统SBD的BV的比较
图2是GA-SBD的BV与传统SBD的对比。可见,除了阳极功函数为4eV,同时r>10nm的两个样品,其他GA-SBD的BV远远大于传统SBD。这进一步地说明了当阳极金属功函数为4eV时,MFP距异质结界面的距离小于10nm才能起到较强的场板作用;而当阳极金属功函数为4.5eV时,这个值至少能提高到14nm。MFP对器件反向电压的钳位作用可以通过电势分布图看出。如图3所示,当r=10nm,WF=4eV时,MFP在反向电压为217V(击穿电压)附近对电势具有有效的钳位作用。可以看到MFP的阴极一侧的电势高达93.3V,而Γ型阳极中金属-2DEG结和金属-AlGaN结分别只承受了V1=1.72V和V2=1.73V的电压。这说明MFP有效地保护了Γ型阳极,同时Γ型阳极中金属-AlGaN结也起到电容作用对下方的电势有进一步的降低作用。
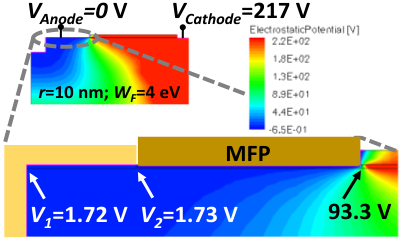
图3 GA-SBD的电势分布
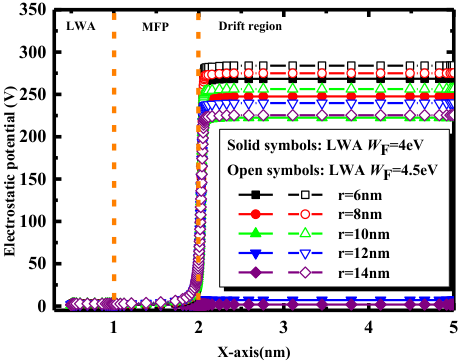
图4 GA-SBD沿着沟道处的电势分布
对上述所有仿真样在击穿前后沿着沟道处的电势进行提取,可以得到如图4所示的电势分布。从图4可看出,沿着沟道处的电势在MFP的阴极一侧骤降至接近0V,这使得Γ型阳极所承受的反向电压仅在1V到2V附近。这证明了所提出的的GA-SBD器件具有有效的反向阻断能力。
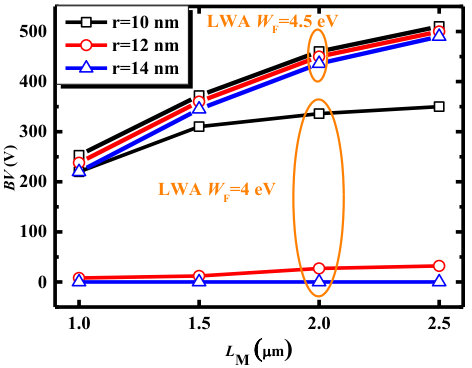
图5 不同MFP长度下GA-SBD的BV
进一步地,针对MFP长度的变化对BV的影响进行研究,设置MFP长度从1μm到2.5μm以步长0.5μm变化。利用上文提到的准静态仿真手段仿真并提取BV,其结果如图5所示。可以看到MFP越长,GA-SBD耐压能力越强。而特别需要提到的一点是,正如前文所证明的,在GA-SBD中MFP属于浅凹槽结构,因此其长度的增加并不会使下方沟道的导电能力恶化。然而,本节并没有详细讨论考虑逐渐增长并接近阴极的MFP和阴极的相互影响。从工艺的角度考虑,当MFP逐渐接近阴极时,沟道处的耗尽区难以有效承担反向电压,即MFP的漏电将会是器件漏电的主要部分,此时增加MFP并不会对整个器件BV的增加有帮助。