首先进行测试的是在片的分立器件的直流特性以评价电路工艺的完成性。图1显示的是半对数坐标下的耗尽型和增强型器件的转移特性对比。提取出来的增强型器件的阈值电压为0.80V,而耗尽型器件的阈值电压为-0.91V。增强型器件的亚阈值摆幅(SS)为151mV/decade,耗尽型的亚阈值摆幅为130mV/decade,在F等离子处理后,SS值降低了22mV/decade。F等离子体处理后的关态漏电流比未处理降低了5倍。
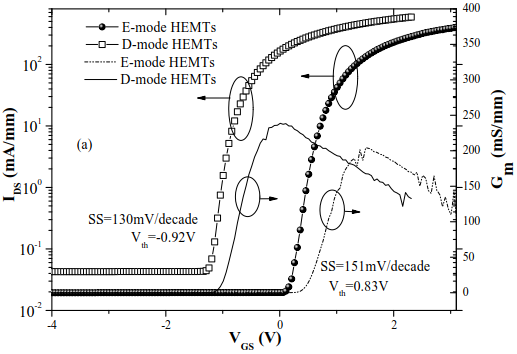
图1 增强型器件和耗尽型器件直流特性对比
GaN基E/D模反相器是SRAM单元电路和电平转化电路到的一个基本组成单元,反相器的性能直接影响到SRAM单元电路和电平转换电路的功能正确性。因此我们对在片的反相器进行测试。图2给出了反相器静态转移特性图。工作在2V的反相器的输出高逻辑电平(VOH)和输出低逻辑电平(VOL)分别为1.97V和0.12V。精心设计的(WE/LE)/(WD/LD)获得了反相器较高的输出逻辑摆幅(VOH-VOL)为1.85V。从静态曲线上提取的逻辑低噪声容限(NML)和逻辑高噪声容限(NML)分别为0.34V和1.07V。反相器的功能正常且提供了高的逻辑摆幅,是实现SRAM单元电路和电平转换电路的基础。
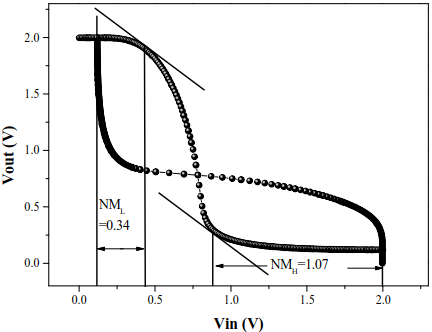
图2 反相器静态直流特性
2. SRAM单元电路测试
对电路的测试我们采用了探针与电路直接相连的在片测试方式。使用4200-SCS半导体参数测试仪与Cascade summit 9000探针平台组建的在片测试系统,将电路信号用探针直接接出,连接至测试设备。吉时利4200-SCS半导体参数仪系统有3个直流测试单元(SMU),三个脉冲模块,一个内建示波器,和一个接地模块(GNDU),能够满足本电路测试的要求。图3给出了SRAM测试的示意图。将1V的VDD接入SRAM单元电路,GNDU接电路的地,将脉冲发生器的ch1和ch2分别接到SRAM的BL和`BL上,并同时连接到示波器的ch1和ch2,脉冲发生器的ch3则同时接到示波器的ch3和字线WL上。分别控制脉冲发生器ch1~ch3的脉冲时序,以观察BL和`BL的电平输出变化。
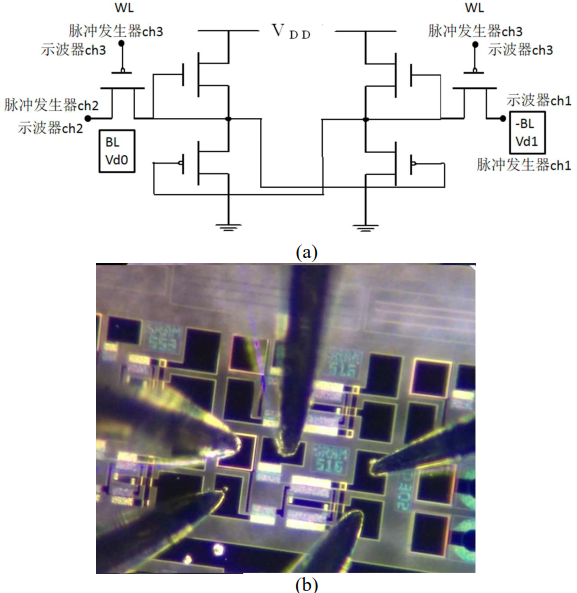
图3 (a)SRAM单元电路的测试示意图(b)探针直接与电路Pad相连的在片电路测试
图4示出的是6管SRAM单元电路的读写时序图,测试时所加的工作电压为1V。在GaN基E/D模SRAM单元电路中,作为电路输出的控制管T5和T6管是增强型HEMT器件,它们的阈值电压为0.80V。在字线WL信号到来后处于开启状态,此时SRAM单元电路被选中,可以写入或者读出,T5和T6的栅极承受的电压同样为电源VDD的值。选则VDD为1V是因为不让T5和T6栅极上的电压过大,从而造成T5和T6的栅肖特基二极管正向流过电路过大,影响T1和T2、T3和T4分压的输出,造成输出电平的改变。如果想使用更大的VDD,今后的工作将T5和T6设计成MOS/MIS-HEMT将能得到理想的结果。
两种不同单元比和上拉比的SRAM电路都能正常工作。CR为2.00,PR为0.08的SRAM的位线输出高电平为0.95V,输出低电平为0.07V;CR为1.67,PR为0.067到的SRAM到的输出高电平为0.90V,输出低电平为0.08V。两种SRAM的CR和PR值相近,且单元内部的反相器的(WE/LE)/(WD/LD)是相同的,只不过WL控制管的栅宽变化10um,因此输出高低电平的值也相近。二者的输出低电平值基本一致,而高电平值相差0.05V,这可能是WL控制管的栅宽变小导致电阻降低造成的。从图4可以看到,写信号可以通过T5和T6管的通断改变SRAM的状态,而在字线WL到来后,SRAM内部存储的状态可以通过导通的T5和T6管传输到BL和`BL端。
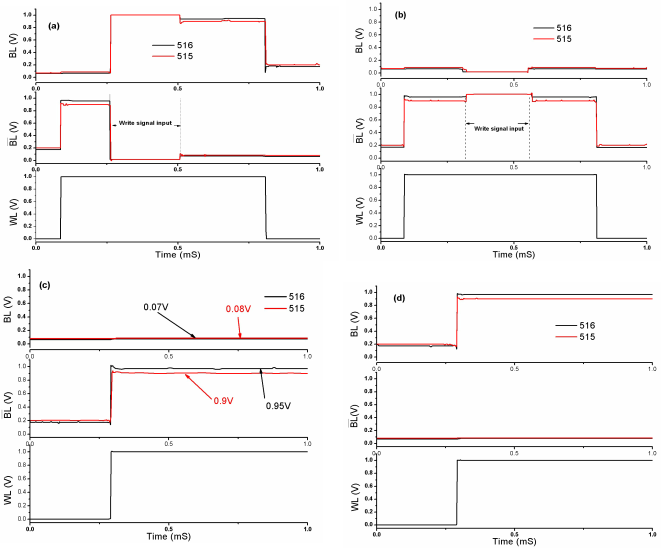
图4 SRAM单元电路读写测试结果(a)写“1”,(b)写“0”,(c)读“0”,and(d)读“1”
3. 电平转换电路测试
图5所示的是典型的使用4个常规HEMT结构二极管的电平转换电路的静态转移曲线。在输入信号变化时,监视Out put1和Out put2的电压值。电路的两个电压设置为6V和-6V,输入电压从代表TTL低电平的0V扫描至TTL高电平3.3V。Out put1的输出高电平和输出低电平分别为-0.42V和-5.31V,Ouput2的输出高电平和输出低电平为-5.14V和-0.63V,两路电压输出的交叉点在-2.8V。电路的翻转电压为0.76V,约为增强型器件的阈值电压。电平转换电路的目的是和移相器等电路集成到一块晶片上以成为整体MMIC,在同样厚度的势垒层上制备的HEMT耗尽型器件的阈值电压约为-1V至-0.8V,因此电平转换电路的输出高电压和低电压能够完全的控制耗尽型HEMT的关断和导通。
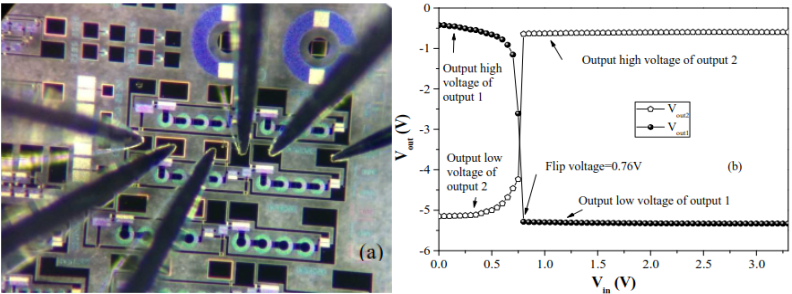
图5 (a)电平转换电路的在片测试照片(b)电平转换电路到的静态转移曲线
当我们考察F处理HEMT结构二极管和常规HEMT在电平转换电路中的区别时发现,同样的+6V和-6V的工作电压,使用F处理HEMT结构二极管的电平转换电路不能正常工作,在输入电压为低时,Out put2输出一个-5.30V的负电压。而当输入电压为高时,电平转换的电压输出没有任何变化。这是因为F处理HEMT结构二极管的肖特基势垒高度/内建势大于常规HEMT结构二极管的缘故。F处理的HEMT结构二极管的肖特基势垒高度比常规HEMT结构二极管的高约0.60eV,当使用4个F处理HEMT结构二极管串联作为电压转换的器件时,总共在F处理HEMT结构二极管上额外降落的电压为2.5V。而常规HEMT结构二极管4个串联时刚好可以将+6V的电压下拉到0V左右,换为F处理二极管后,不考虑寄生HEMT的分压影响,F处理HEMT结构二极管将Out put1的输入在原来基础上再下拉2.50V,Out put1的电压在输入电压为低时已经下降到耗尽型管T3的阈值电压以下,第二路输出失效。
为了考察F处理HEMT结构二极管在电平转换电路中与常规HEMT结构二极管的差异,我们将电平转换电路的工作电压在原来基础上上升3V,使F处理HEMT结构二极管组成的电路也能正常工作。但是此时的常规性HEMT结构二极管的输出高电平已经达到2V,不符合耗尽型HEMT的控制使用,这里仅为了对比常规和F处理HEMT结构二极管的差别。图6画出了常规HEMT结构二极管和F处理HEMT结构二极管组成的电平转换电路对比,从图上可以看到当工作电压提高3V时,常规HEMT结构二极管组成的电路的Out put1输出高电平提高了2.68V,并非为3V,负电压方向则降低了1.53V,Out put2输出高电平提高了2.98V,负电压方向降低了0.95V。电源电压的升高提高了电路整体的电流,因此也提高串联在寄生HEMT源漏端的电流,它们将分得更多的电压,因此Out put1和Out put2的电压输出值并没有按照工作电压的增加值而增加,而是有一定的偏移。同样工作电压下,使用F处理HEMT结构二极管的电路比常规HEMT结构二极管的电路能更有效的降低电路的电压。两路输出的高电平值为实际在二极管上降低的电压的结果,我们在此对比高输出电平差值。F处理的HEMT结构二极管的Out put1的输出高电平值比常规HEMT高2.06V,Out put2的输出高电平值比常规HEMT高2.28V,相比4个F处理HEMT结构二极管串联所增加的内建势2.5V还是有部分偏差。这主要来源于寄生HEMT的影响。
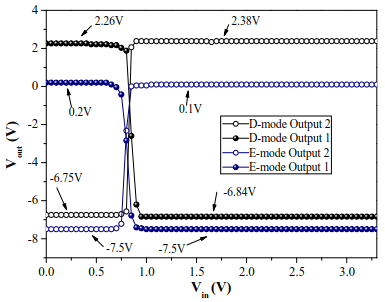
图6 常规HEMT结构二极管和F处理HEMT结构二极管组成的电平转换电路对比
为了考察电平转换电路输出电压跟随工作电压的能力,增加工作电压,测量Out put1和Out put2的输出变化情况。图7示出了常规HEMT结构二极管做为电压转换组件的电压变化图。从图中可以看到,随着工作电压的增加,输出电压都跟随着电源电压的变化。输出高电平的电压随着电压的增加从工作电压为6V时的-0.60V线性的增加到了10V时的3.04V,但是增加的速率却低于工作电压的增加。从图7(b)提取的输出高电平的增加斜率为0.86。若提取的斜率为1,则说明电压的转换仅由HEMT结构二极管决定,串联的HEMT结构二极管上降落固定的电势。而提取的斜率为0.86,这说明改变输出电压的因素并非只有HEMT结构二极管的内建势高度,还包括寄生的HEMT。图7(c)画出了在二极管上降落的电压,由正电源电压减去第一级输出高电平得到。从图7(c)可更清楚地看到,随着电源电压的增加,在串联HEMT结构二极管上降落的压降越来越大,第一级传输电路上降落的电压从VDD=6V时的6.4V上升到VDD=10V时的7.8V。平均每个HEMT结构二极管上降落的电压从VDD=6V时的1.6V,增大到了VDD=10V的1.95V。而第二级的降落规律并不明显,这是因为第二级是受耗尽型HEMT控制的,第一级输出电压的下降将降低第二级导通的电流。

图7 改变工作电压常规HEMT结构二极管的电压偏移量。(a)不同工作电压下的静态输入-输出曲线(b)不同工作电压下的Vout变化曲线(c)不同工作电压HEMT结构二极管上偏转的电压
图8所示的F处理HEMT结构二极管做为电压转换元件的电压变化图,与图7的对比我们可以看到,F处理HEMT结构二极管作为电压转换组件的电平转换电路更能够有效地进行电压的转换,斜率接近1的输出电压-电源电压关系说明电路绝大部分的电压转换是由F处理HEMT结构二极管完成的,这得益与F处理HEMT结构二极管1.98eV的内建势。平均降落在每个F处理HEMT结构二极管上的电压为2.25V,且随着电源电压的增加变化程度仅为0.10V。更大的内建势/势垒高度极大地减小在寄生串联HEMT有源电子上的电压,从而也减小了这些器件对分压回路上的影响。

图8 改变工作电压F处理HEMT结构二极管的电压偏移量。(a)不同工作电压下的静态输入-输出曲线(b)不同工作电压下的Vout变化曲线(c)不同工作电压HEMT结构二极管上偏转的电压
图9给出了9V工作下5个HEMT结构二极管和4个HEMT二极不同的输出电压对比。增加一个HEMT结构二极管的电压偏移量为1.99V。增加一个HEMT结构二极管本来应该使得电压漂移为常规HEMT结构二极管的内建电势/势垒高度值,但是1.99V的偏移量明显的高于内建电势/势垒高度值。由此可见1.8um栅源/栅漏间距对分压回路的影响。通过增加或减少HEMT结构二极管数量来改变电压转换值的方法必须考虑寄生HEMT,在仿真设计和版图设计时加以考虑。

图9 9V工作电压下,5个HEMT结构二极管串联和4个二极管串联的输出电压对比
4. 电平转换电路温度测试
图10给出了电平转移电路的输出电压随温度变化的关系图。输出电压随着温度的增加总体上的漂移量不大,但是呈现出了轻微的输出电压减小的趋势。温度从25℃增加到200℃时,输出高电平最大电压的偏移量约为0.42V,而输出低电平偏移量约为0.2V。常规HEMT结构二极管和F处理HEMT结构二极管组成的电路的输出随温度变化的趋势基本一致,没有体现出明显的差别。
