首先在Sentaurus平台里的SDE模块中建立仿真结构模型,其结构与几何参数如图1所示。另外,在SDevice模块中,对所建立的模型材料参数进行设定,具体设置如表1所示。
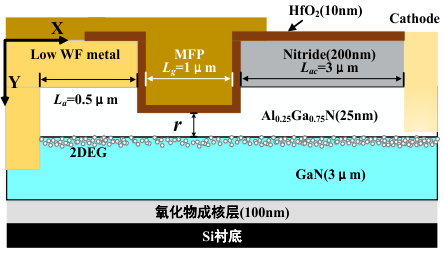
图1 GA-SBD的仿真结构示意图
对器件进行正向导通的仿真,即模拟阳极电压不断升高的过程,记录每个阳极电压点对应的电流。为了获得真实的仿真结果,仿真中对MFP右侧、沟道处、阳极两个结附近的Mesh做了增密处理。在仿真研究中,定义开启电压VT为整个器件正向电流密度为1mA/mm时的阳极电压;定义击穿电压BV为整个器件反向电流密度为1mA/mm时的阴极电压。
表1 GA-SBD的仿真参数设置


图2 阳极金属功函数为4eV时GA-SBD的I-V曲线
图2所示的是GA-SBD当阳极金属功函数为4eV时,不同r条件下的I-V特性图。随着�不断降低,器件的开启电压逐渐右移。这和之前的分析一致,即MFP的深度直接影响其下的2DEG浓度,当MFP过深时,MISFET的阈值电压能主导整个器件的开启电压。另外,也同样由于MFP对下方2DEG的耗尽,器件的漏电流随MFP的加深而降低。这说明如果把MFP看做有效的场板,在一定范围内,其越深则场板效果越好,但同样也会对器件导通性能有较大地影响。图3所示的是阳极金属功函数为4eV时GA-SBD的导通特性。可以明显看出,当器件MFP深度相同时,具有高功函数阳极的GA-SBD漏电更低,同时开启电压更高。
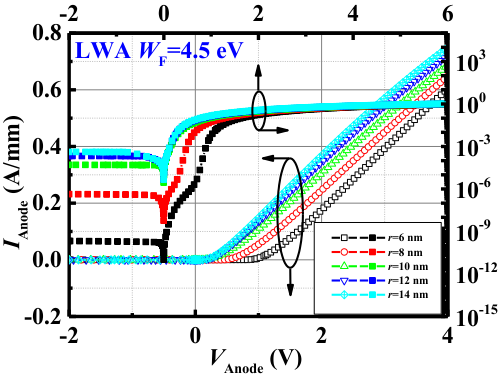
图3 阳极金属功函数为4.5eV时GA-SBD的I-V曲线
从图2与图3中可以清晰看出,当AlGaN层在MFP的凹槽下的剩余厚度小于8nm时器件的I-V曲线有膝点。膝点位置与阳极功函数选取无关,当剩余厚度r分别为6nm与8nm时,膝点电压分别约为0.2V和0.6V。这是由于当MFP下AlGaN层厚度低于8nm后,MFP下异质结沟道处的导带会高于费米能级并显著提升,这对于2DEG的影响是巨大的。基本上,当MFP下AlGaN层厚度低于8nm后,可以认为MISFET结构是准增强型的。而MFP的阈值电压应该就是膝点电压,当VA大于MISFET结构阈值电压即MISFET开启时,整个二极管整流器电流剧烈上升,形成膝点。另外,可以看到膝点位置都在二极管整流器开启之前,这说明MFP对二极管整流器的开启没有太大的影响,这也从侧面证明了GA-SBD原理的科学性。图4所示的是GA-SBD在阳极电压较低和较高时阳极附近的电流密度分布(此样品阳极功函数为4.2eV而MFP下势垒层剩余厚度为6nm)。可以看出当所有样品的阳极电压较低时(约0.12V),器件只有金属-2DEG结输运电流。而当阳极电压较高时(约6V),器件金属-2DEG结与金属-AlGaN结同时输运电流。
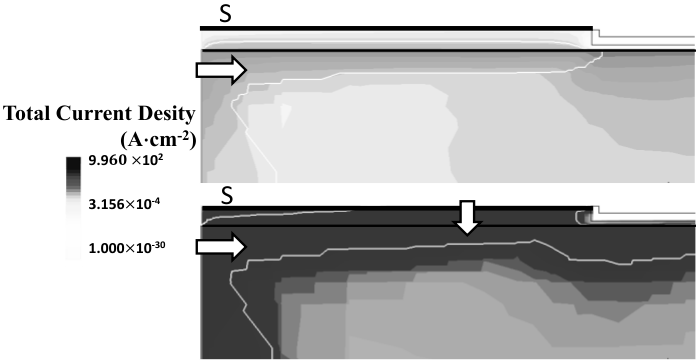
图4 不同正向阳极电压下的GA-SBD阳极附近电流密度分布
对器件的开启电压和r进行提取可得图5所示的结果。本文所提出的GA-SBD开启电压可以低至0.2V以下。而r=10nm,VF=4eV的器件开启电压低至0.08V,这极大地接近了功率整流器的理想值。
除了上文已经提到并详细分析过的r深度与开启电压的关系之外,从图5可以看出当r大于10nm以后,器件的开启电压基本没有变化。这个结论对实验制备甚至工业化量产具有重要意义。因为在GA-SBD的制备过程中,形成MFP必须使用刻蚀工艺,而目前的刻蚀工艺很难兼顾精确性、稳定性与速率。而GA-SBD的MFP即可在器件结构上有效避免这个矛盾。即在一定的MFP范围内(仿真认为是4nm左右),器件开启电压并不受MFP很大影响。而此时器件在阳极电压为3V时的电流变化也很小(<0.09mA/mm),这说明GA-SBD的开启与导通两个特性具有很强的工艺容错性。
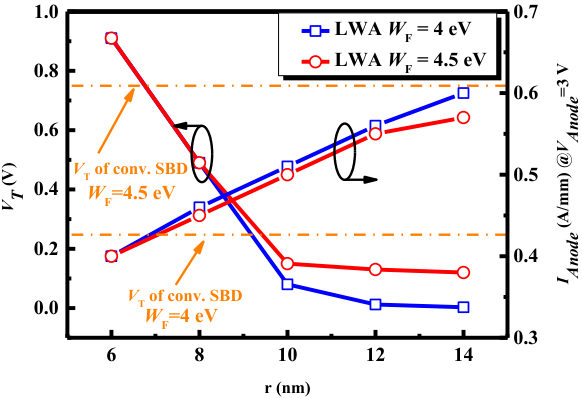
图5 不同的r条件下GA-SBD开启电压和VA=3V时器件的电流
