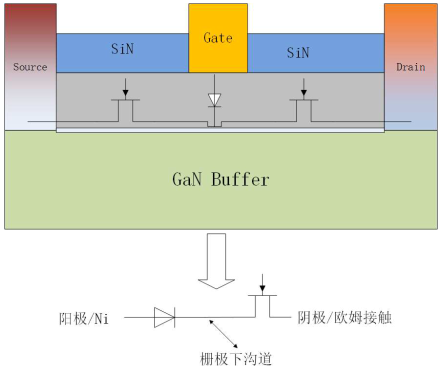
图1 Ni-AlGaN/GaN肖特基二极管结构示意图
在实际AlGaN/GaNHEMT器件的使用中,常见的结构是使用栅极与AlGaN势垒层的Ni-AlGaN接触作为肖特基二极管结构。栅极作为二极管的阳极,而使用源极或者漏极的欧姆接触作为肖特基二极管的阴极,如图1所示。这种结构实际上是源极和漏极相连的HEMT结构。从图1中可以看出,Ni-AlGaN/GaN肖特基二极管的肖特基结总是需要通过2DEG与阴极接触金属接触,栅金属-AlGaN/GaN形成的肖特基结“沉浸”在2DEG的环绕之中。不管如何缩短栅源或者栅漏的距离,HEMT结构二极管结构之中总需要一段栅源、栅漏间距将Ni-AlGaN/GaN肖特基结与阴极的欧姆金属相连。这段将电流引出的栅源或栅漏区域可以等效看成一只栅极悬空的HEMT,也即一支有源电阻。这样,实际的Ni-AlGaN/GaN肖特基二极管可以等效成为图1下半部分所示的电路拓扑结构:由一个理想的本征Ni-AlGaN/GaN肖特基二极管,和一个栅极悬空的HEMT串联而成。实际测试中,无论我们是测量HEMT器件中的栅源和栅漏二极管,还是测量较大肖特基接触面积的二极管,所测量出来的I-V特性都是图1所示的结构。如果是只考虑源漏间电流的HEMT放大器等电路,可以忽略实际结构和理想结构的区别。但是如果是我们后面章节中所要制备的GaN基E/D模电路,这种理想和实际结构的区别就能很明显地影响到电路的设计指标和性能。后续制备的电平转换电路,主要是通过二极管的内建电势/肖特基势垒进行电压的偏移。因此我们设计了不同结构尺寸的Ni-AlGaN/GaN肖特基二极管进行大偏置下的测试,以找出寄生HEMT对二极管实际测试的影响。
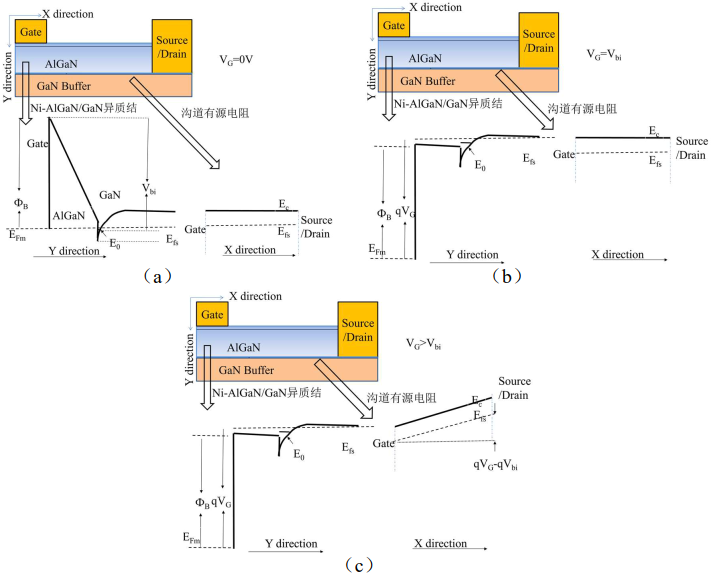
图2 正向大偏置下HEMT结构二极管的电压降和能带图(a)VG=0V(b)VG=Vbi(c)VG>Vbi
从图2(a)可以看到,电子从栅极金属往半导体方向运动时需要跨越的势垒高度为肖特基势垒qϕB,而电子从AlGaN/GaN界面处向金属方向运动时所需跨越的势垒高度是肖特基金属和异质结形成的内建势qVbi。由于在AlGaN/GaN异质结处的局域化量子效应,电子的所处的最低能级并非是导带底EC,而是AlGaN/GaN异质结界面处所形成的三角势阱中的基态能级E0。这使得内建势Vbi在数值上依照不同的2DEG密度,稍微大于肖特基势垒高度qϕB。当将加在栅极上的正向电压开始增大时,依照不同的电压偏置大小,电压将主要降落在不同的结构部分,从而呈现不同的I-V特性。当0<VG<Vbi时,由于内建势的存在,HEMT结构二极管的电阻远远大于栅漏、栅源区域寄生的悬空栅极HEMT的电阻,因此所有的电压都将降落在HEMT肖特基结上。导致随着电压的增加,半导体侧的能带被不断抬高,因此以热电子发射形式通过势垒的载流子将随着VG的增加以指数形式增加。如图2(b)所示,当VG=Vbi时,从E0处往肖特基金属运动的电子将无需跨越任何能量势垒。此后继续增加HEMT结构二极管栅极的电压,减掉降落在Ni-AlGaN/GaN肖特基接触上的内建电势差Vbi,其余的部分(VG-Vbi)全部降落在栅源/栅漏区域寄生的悬空栅极HEMT之上。需要注意的是,栅源/栅漏部分寄生的悬空栅极HEMT并非是纯电阻形式存在的,和HEMT一样,存在着线性区和饱和区。当平均电场(VG-Vbi)/LGD小于饱和速度临界电场时,I-V特性呈现线性电阻特性,当平均电场(VG-Vbi)/LGD大于饱和速度临界电场时,和HEMT一样,总的电流等于HEMT器件的饱和电流。
