在反向应力的过程中,HEMT器件或者HEMT结构二极管并没有电流经过,或者电流很小,主要影响器件性能退化的电学参数是电场。我们首先进行栅台阶应力的实验。将源极和漏极分别接到地,同时在栅极加上负向的电压,这样相当于在HEMT结构二极管上加上负压。同时每隔100秒增加栅极的负压,每次将栅极的电压减小5V,以找到反向应力试验中较为普遍存在的逆压电效应的关键点。逆压电效应理论认为高负压下的器件退化的主要原因非电流和热电子,而是加在势垒层上的电场。强的电场与势垒层的应力耦合,势垒层的应力会相应调整到与当前电场相对应的数值,在AlGaN/GaN异质结结构中势垒层晶格常数须变大以适应电场,当超过一定的临界值便引起晶格弛豫,进而引起器件的退化。台阶应力增大的过程也是电场增大的过程,同时每个反向应力100秒的应力时间考察当前应力是否造成晶格弛豫、缺陷形成。逐渐增加的台阶应力可以清晰地找到对晶格造成永久损伤的临界电压。图1给出的是常规HEMT结构二极管和F注入HEMT结构二极管的栅极电流和应力时间的关系。
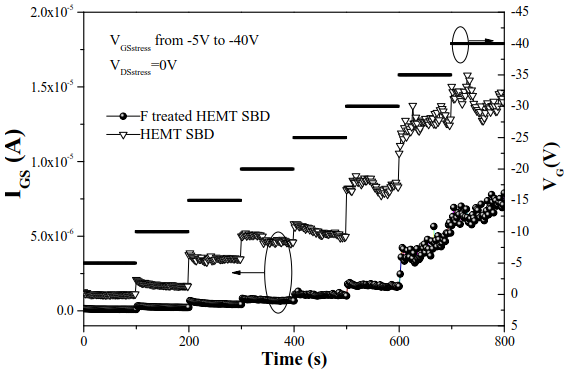
图1 常规HEMT结构二极管和F处理HEMT结构二极管栅极电流随反向应力的变化
常规HEMT结构二极管和F处理HEMT结构二极管在整体的应力加载过程的趋势是一样的,即每个负压间隔都增加了栅电流。这些增加的电流来源于栅极的边缘电流,也就是逆压电效应发生的物理位置。在临界电压之前,增加的负栅压所引起的增加的电流增大若停止应力,栅极电流可以恢复其原来大小。而超过临界电压之后,增加的栅极电流则不能再恢复到原来的数值。从图上看,临界电压的测试值对于常规HEMT结构二极管约为-25V,超过-25V电压
后,栅电流的噪声变得非常大。而对于F处理HEMT结构二极管为-30V。在临界电压点附近,栅极电流的噪声变得相当严重。这里需要说明的是,本次测试的临界测试值-25V低于第三章在研究HEMT结构二极管反向漏电机制时最大的负偏压-40V,这是因为两个实验使用的器件是在不同的外延晶片上制备的。临界电压受到材料生长,工艺等影响,每个材料表现出来的临界电压不同。尽管临界电压在各个材料间没有固定值和对比性,但是同一材料上制备的器件的对比还是合理的。
一个有意思的现象可以在每次应力的刚开始时间被观察到,在临界电压到来之前,随着每次应力间隔的进行栅极漏电刚开始电流值会有一个下降的趋势,这个可以从图2可以看到。图2给出了在栅压为-5V的时候的电流变化图,开始施加应力的最初20秒,常规HEMT结构二极管的栅极漏电从6.3×10-7A下降到了5.4×10-7A,减小量为14%;而F处理HEMT结构二极管的电流在40秒后从1.5×10-7A下降到了1×10-7A,减小量约为33%。可见,在不同偏置下,势垒层中存在着一个电荷注入的过程,注入的电子被势垒层或势垒层界面的陷阱捕捉,在一定程度上提高了势垒高度,因此轻微地降低了栅极电流。电荷注入的过程是电子从栅极跨越或隧穿过肖特基势垒,被势垒层内部的固有陷阱捕获,因此抬高了肖特基势垒高度,进而减小了栅极电流。若没有新的陷阱产生,只是势垒层原来陷阱的捕捉电子,那么这个栅极漏电变小的恢复过程是始终存在的。而当逆压电效应的临界电压到来之后,栅极漏端产生了应力释放造成的导电通道,则栅极漏电变小的恢复过程就无法再出现,此时可以判断逆压电效应的临界电压值。在栅极电流变化不算太剧烈的情况下可以从栅极漏电恢复情况判断临界电压的数值。
增加的栅极电压在栅极漏端不断地提高电场,在电场大于1.80MV/cm后,电子以F-N隧穿的方式穿过势垒层。图2所示的F处理HEMT结构肖特基二极管反向电流恢复时间比常规HEMT结构二极管慢的原因,作者认为是注入到势垒层的F离子在退火等工艺后,部分地扩散到栅极以外的区域,在栅极漏端附近的区域也存在少量的F离子。这些少量的F离子也能在一定程度上提高势垒高度,因而一方面由栅极通过FN隧穿经过势垒的栅极漏电流减小,另一方面,隧穿概率的提高也使得陷阱充放电的时间增加,从而使得栅极恢复时间变长。
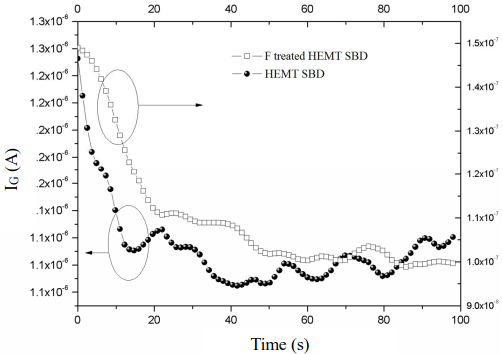
图2 VGS=-5V时栅电流在最初100秒内随应力时间的变化
图3给出的是栅压为低于临界电压的-22V的偏压下,常规HEMT结构二极管和F处理HEMT结构二极管栅极10000秒漏电变化情况,时间的取值方式为对数方式。前100秒栅电流减小的趋势如上讨论,这种陷阱捕捉相关的电流减小结束后,无论常规HEMT结构二极管还是F处理HEMT结构二极管的电流都慢慢增大。常规性HEMT结构二极管的电流在1000秒左右时有一个突然的增加过程到大约原电流的四倍。而F处理HEMT结构二极管的栅电流则比较平稳,在1000秒后的时间内都维持一个相对稳定的值。
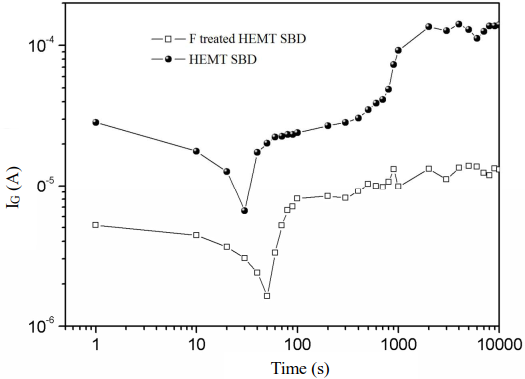
图3 10000秒HEMT结构二极管和F处理二极管电流的变化曲线
F处理HEMT结构二极管的反向关态应力可靠性要比常规HEMT结构二极管的优秀的原因可以用两种器件栅下/栅极附近电场分布的不同来解释。反向偏压下并无电流的影响,主要的作用为电场作用。在第三章中我们讨论过栅极漏端附近的电场分布情况,栅极漏端的电场是饱和电场再叠加一个附加的横向耗尽层感生电场共同组成的,而栅下F离子的注入,降低了栅下饱和电场的大小。以下我们通过实际计算来说明F离子的引入如何减小了栅下区域的饱和电场。图4所示的是常规HEMT和F处理HEMT栅极区域能带图。虚线部分为常规HEMT,实线为F注入HEMT,Δd为F处理刻蚀的深度。在图4标识的坐标轴中,E(0,V)为x=0处,VG=V时的电场强度。在耗尽近似下,对于任何一个电压V:

在金属/势垒层界面使用高斯定律:


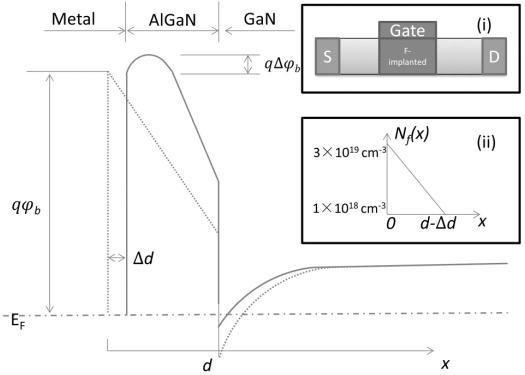
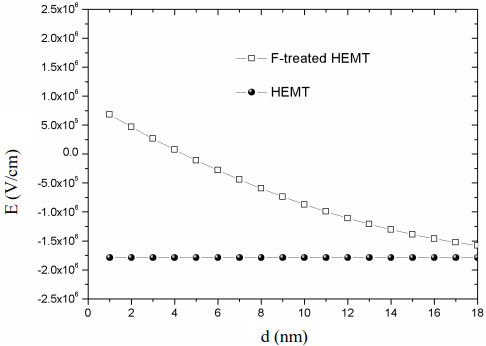
图5 计算的VG=-4V时势垒层内电场分布图
图5画出的是在VG=-4V时的常规HEMT和F处理HEMT势垒层内的电场分布图。此时,无论是常规HEMT结构二极管还是F处理HEMT结构二极管,栅电压已经小于阈值电压。栅极下的电场已经到达了饱和值,继续增加栅极负向电压,栅极下的电场保持不变,栅极漏端附近的电场持续增加。在假设势垒层没有任何掺杂的情况下,常规HEMT势垒层内的电场处处相等,而F处理HEMT势垒层在AlGaN/GaN界面处为最大的负值,电场从AlGaN/GaN界面向栅极的方向电场的绝对值先减小,在离栅极/势垒层界面3nm处电场为零,在栅极/势垒层界面往异质结方向3nm的范围内,电场方向为较小的正向值。对比常规HEMT和F处理HEMT整个势垒层中的电场分布,常规HEMT在-4V的栅极电压下(这时已经达到负向势垒层最大饱和电场)的平均电场要大于F处理HEMT。如上章讨论的结果,饱和电场达到后,纵向电场的增加只在栅极漏端附近的一百到几百纳米的范围增加。因此关态反向应力电压低于阈值电压后,常规HEMT器件的在同样的栅电压下承受的电场强度要大于F处理HEMT器件,因此造成晶格应力弛豫的临界电压比F处理HEMT的临界电压小,关态反向应力电压下的退化也比F处理HEMT结构二极管要严重。
