1. 器件结构特点
器件结构如图1所示,器件阳极由肖特基栅极和欧姆阳极金属短接构成,器件阴极为欧姆金属。肖特基栅极采用凹槽刻蚀技术控制阳极与阴极之间沟道二维电子气浓度来调控正向开启电压,在栅金属下淀积高k介质以降低反向泄漏电流。该新型HFET结构可灵活调控正向开启电压,同时提高器件反向阻断能力。
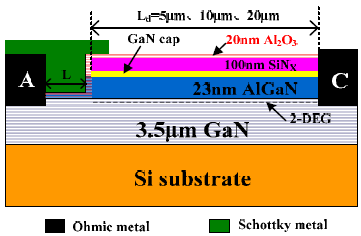
图1 新型AlGaN/GaN HFET功率器件结构横截面示意图
该新型HFET功率器件在结构上具有以下特点:
(1)凹槽栅结构。通过在紧挨阳极欧姆金属的沟道处进行凹槽栅刻蚀,来耗尽凹槽处的2-DEG,从而实现器件的开启和关断。
(2)Al2O3介质。原子层淀积工艺生长的Al2O3为高k介质层,具有较好的绝缘性,可以降低器件的反向泄漏电流。
(3)混合阳极结构。器件阳极由肖特基阳极与欧姆阳极直接接触形成。肖特基阳极可以控制沟道的开启和关断,欧姆阳极可以降低器件导通电阻,因此混合阳极结构既可以控制器件开关由降低了器件的导通电阻,有效的降低了器件的开关损耗。
2. 器件制备工艺流程
本实验使用的AlGaN/GaN晶圆为基于4英寸Si衬底的国产MOCVD外延片。材料由下至上依次为3.5µm厚的非掺杂GaN缓冲层,1nm厚的AlN空间插入层,23nm厚的AlGaN势垒层,2nm厚的GaN帽层。其中,AlGaN势垒层中的Al组份为25%,沟道二维电子气浓度为8.72×1012cm-2,方块电阻约为558Ω/□。器件尺寸如下:凹槽长L=2µm,漂移区长度Ld为5µm、10µm、20µm,器件有源区宽度W=50µm。
新型AlGaN/GaN HFET器件-绝缘栅混合阳极二极管(MG-HAD)制备过程如图2所示。本次实验主要是制备实验性质的小器件,并未制备大电流器件,因此未做加厚金属,另外本次实验并未做标记金属。器件隔离工艺选用ICP刻蚀台面,刻蚀至GaN缓冲层,刻蚀深度约为300nm。钝化工艺选择PECVD淀积100nm的SiNx。凹槽刻蚀工艺使用Cl2/BCl3等离子体常温ICP刻蚀,刻蚀深度约为21nm。介质淀积选用300℃下原子层淀积工艺,淀积20nm的Al2O3,然后在快速退火炉中进行400℃时长10分钟的快速热退火,以改善质量,使其更加致密。肖特基金属为40nm/450nm厚的Ni/Au采用电子束蒸发工艺。

图2 新型AlGaN/GaN HFET器件(MG-HAD)工艺流程
