激光剥离技术(LLO, laser lift-off)是采用紫外光波段的激光光源透过蓝宝石衬底辐照样品,使蓝宝石/GaN界面处的GaN发生热分解生成金属Ga以及N2。N2逸出,加热样品至金属Ga的熔点(29℃),使Ga融化,即能实现蓝宝石与GaN的分离。
目前在商品化的LED中,在完成电极制备等工艺后,必须对蓝宝石衬底进行减薄、研磨抛光等步骤。蓝宝石由于硬度高(莫氏9.5,仅次于莫氏10.0的金刚石)、脆性大,对其机械加工十分困难,这样不仅加大了器件工艺难度,而且蓝宝石无法重复利用。如果利用激光剥离技术将 GaN LED外延薄膜转移到Si衬底,不仅可以解决蓝宝石作为GaN薄膜衬底的缺点,而且可以保留蓝宝石衬底,实现衬底的重复利用,节约成本,对实际生产有十分重要的意义。本文通过激光剥离技术,实现大面积GaN LED激光剥离,而且完整的保留了蓝宝石衬底,并且在剥离后的衬底上重新生长GaN基LED器件结构外延薄膜,并对其进行对比研究。
1. 实验过程
实验采用LP-MOCVD系统生长的In GaN/ GaN MQW’s LED外延片。实验采用LP-MOCVD系统在蓝宝石(0001)衬底上生长InGaN/ GaN MQW LED结构。以纯度6N的TM Ga. TM In和B-NH3分别为Ga源、In源和N源。以SiH4和CP2Mg分别作为n型和p型掺杂剂,以高纯(7N以上)的N2和H2混合气作为载气。结构如下:在(0001)晶向的Al2O3衬底上依次生GaN缓冲层,掺Si的n-GaN,5个周期的InGaN/GaN MQW和掺Mg的p-GaN,总厚度约为3.8µm。剥离后的衬底上的GaN LED与常规衬底上的GaN LED分别为样品A和样品B。
激光剥离的具体过程如下: GaN LED外延片正面用环氧树脂或者金属粘在S衬底上,采用波长248nm、脉冲宽度30ns的KrF准分子激光器( COMPex100)的激光作辐照光源,并同时用红外灯照射加热样品,激光扫描完样品后,用稀HCI浸泡样品,除去GaN上的金属Ga,使蓝宝石衬底与外延片分离,得到Si衬底支撑的φ2×25.4 mm GaN LED外延薄膜。
对于在剥离后的衬底上重新生长In GaN/ GaN MQW's LED器件结构外延薄膜,为了便于比较,本文采用与一个新的常规衬底同一炉进行生长,对它们的性能进行比较。
2. 结果与讨论
2.1剥离前后的GaN性质
采用能量密度为500mJ/cm2的激光辐照样品后,样品在蓝宝石/GaN界面出现成片银白色的亮点,将样品浸入HCl溶液后,成功地将2 inch GaN薄膜从蓝宝石上分离。剥离后的GaN LED的在金相显微镜下观察非常完整,没有裂纹,如图1所示。利用扫描电镜(SEM)对转移衬底后的样品的解理面进行观察,可以看到Si衬底上有将近3.67 µm GaN外延层薄膜,且十分完整,如图2所示。

图1 剥离后的GaN样品显微镜

图2 剥离后的GaN/胶/Si SEM照片
转移衬底后的GaN LED结构薄膜PL光谱如图3所示,可以明显地看到GaN的带边363nm发射峰,它相对较弱,因为根据样品的透射谱推算波长为325nm的激光在样品中的透射深度只有0.52µm,这一厚度的GaN是Al2O3衬底上生长GaN材料初期的材料,它相对质量较差,另外本实验由于剥离分解局限于Al2O3和GaN界面处的GaN缓冲层而样品在缓神层之上又生长了一层3µm的n-GaN,所以此时PL光诺没有测量到lnGaN/GaN的多量子阱区的发光。

图3 剥离后GaN LED结构的PL谱
我们同样对样品(0002)面进行ω-2θ扫描。未剥离前的样品有2级卫星峰,而剥离后的样品有1级卫星峰,剥离后的样品保留了lnGaN/GaN有源层结构,但是由于测试的位置接近GaN缓冲层,晶体缺陷密度比较高,表面不平整,所以衍射卫星峰级数减少。
图4显示了剥离后的GaN表面原子力显微镜照片。RMS均方根粗糙度为16.04nm。表明剥离后表面较为平整,但是比起未剥离时的RMS(0.6nm)粗糙度较大,一方面是由于在剥离过程中GaN薄膜的热分解引起的;另一方面是由于剥离开的表面原来与蓝宝石相连,蓝宝石和GaN的晶格失配较大。对制备基于激光剥离技术的GaN基LED器件而言,n-GaN为出光面,表面粗糙度提高有利于提高光提取效率。相对于传统的GaN表面粗糙技术,LLO更简单且有效。
2.2在剥离后的衬底上重新生长的GaN LED性质
将剥离后得到的蓝宝石衬底正面抛光,同一条件下放入另外一片常规蓝宝石衬底进行生长对比。图5显示了样品A和样品B正面光致发光谱图的对比。样品A峰值波长为450nm,半峰宽为28nm。而样品B的峰值波长为458mm,半峰宽为21nm。样品A比样品B的PL发光峰蓝移了8nm。

图4 剥离后的GaN AFM照片
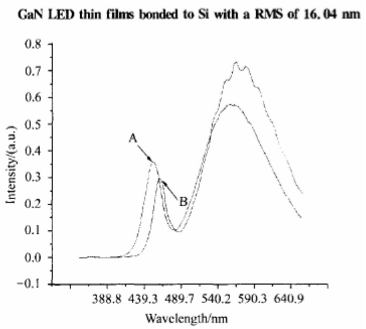
图5 样品A、B的PL谱
InGaN MQW LED的发光波长取决于阱层的组分、厚度及阱层的压应力大小。样品A和样品B的生长条件相同,故可以认为引起波长发生变化的主要原因是两种LED所受的应力不同,使 InGaN量子阱发光层的极化场发生了变化。我们对两个样品分别进行拉曼( Raman)测试。实验采用共焦显微拉曼光谱仪,激光线为Ar+激光器514.5nm谱线。采用背向散射几何配置;激发光为非偏振光,收集光谱也不做检偏振处理,由根据选择定则在Z(X-)Z配置下应该出现E2和A1(LO两种模式。图6为样品A和样品B的拉曼光谱。样品A的E2和A1(LO)振动模位于570.53cm-1和740cm-1处,而样品B的E2和A1(LO)模位于570.73cm-1和740cm-1处。位于418和752cm-1附近的峰是由蓝宝石衬底产生的。由于外延膜和衬底之间的晶格和热失配,样品中可能存在双轴应力,E2模的位置与样品中的应力有关,可以以此检验样品中存在的应力。样品A相对于样品B的E2模式拉曼峰变化很小,向低波数方向红移为0.2cm-1,因此认为由于衬底正面抛光使样品A的InGaN量子阱受到的压应力减小,它的极化电场减弱。因而在样品A中,由极化场导致的量子限制Stark效应(PQCSE)相应的减弱,它导致量子阱能带倾斜程度相应减小,造成波长蓝移。

图6 样品A和样品B的拉曼谱
对样品A和样品B进行(0002)X射线双晶衍射谱测量。样品A可以观察到1级卫星峰,而样品B可以观察到3级In-GaN量子阱的卫星峰结构,而且主峰展宽小于样品A,说明样品B的 InGaN多量子阱具有良好的周期结构和陡直的界面,晶体质量好于样品A。
对样品A和B的进行摇摆曲线测量表明样品A的FWHM为639”,样品B的FWHM为240”,样品A的半高宽较样品B大。B. Heying等人曾报道了对称X射线衍射(0002)面扫描峰的加宽主要是由螺旋位错造成的,所以A的晶体质量不如样品B。两个样品生长条件都相同,引起的原因可能是蓝宝石衬底的抛光。蓝宝石衬底的抛光工艺较为复杂,只有化学机械抛光可以真正使蓝宝石衬底实现全局平面化。但在国内仍有一定的局限性。由于实验局限,正面机械抛光的过程中产生加工损伤,表面出现微划痕,造成晶体质量下降。在后续的试验中对蓝宝石衬底的抛光工艺进行研究,以减小抛光对衬底的影响提高衬底质量。
3. 结论
利用KrF准分子激光,在能量密度500mJ/cm2的条件下成功的实现将MOCVD生长的GaN基LED外延膜完整地从蓝宝石衬底上分离。激光剥离后的AFM扫描和XRD谱表明剥离前后外延膜的质量并未明显改变。之后在剥离掉的蓝宝石(a-Al2O3)衬底上成功的外延生长InGaN/ GaN MQW's LED器件结构,并与相同生长条件下常规蓝宝石衬底上生长的GaN LED对比。PL谱和拉曼测试表明由于衬底抛光使GaN LED外延膜应力释放,发生波长蓝移。通过XRD对比,表明机械抛光对外延膜质量产生不利影响,为了提高质量必须对剥离下来的蓝宝石衬底的抛光工艺进行摸索和改造。
