1. SBD结构设计
目前GaN基肖特基二极管最常见的两种结构如图1所示,分别是横向肖特基二极管和纵向肖特基二极管。横向肖特基二极管的优点在于使用了AlGan/Gan异质结结构,在不进行掺杂的情况下也能够有电流产生,充分利用了现有AlGan/Gan HEMT的研究成果,缺点在于这种结构会增加器件的面积和成本,另外它的正向电流密度通常也比较小。纵向结构的肖特基二极管主要用在电力电子器件方面,其电流比较大,有许多研究人员采用从外延片上剥离下来的厚GaN材料来制作纵向结构肖特基二极管。由于这种外延片上分布着高密度的缺陷,所以制作出的二极管虽然取得了较大的电流,但其反向漏电流也十分大,而这也使得实际的击穿电压远远小于GaN基二极管击穿电压的理论水平。关于纵向结构GaN肖特基二极管的研究现在主要还是处于仿真分析和改善材料特性的阶段。
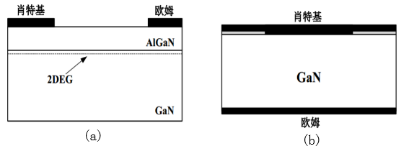
图1 GaN基肖特基二极管结构示意图 (a)横向结构 (b)纵向结构
本文研究的基于AlGaN/GaN异质结多沟道结构的横冋肖特基二极管,器件结构如图2所示。两个100nmm厚的阳极和阴极分布在异质结多沟道结构的两端,其下方是AlGaN/GaN异质结多沟道结构和GaN衬底。AlGaN/GaN异质结多沟道结构由多个周期的AlGaN势垒层和GaN沟道层组成,该多沟道有2到6个周期,每个周期中势垒层和沟道层的厚度都在10-20nm。

图2 AlGaN/GaN异质结多沟道结构横向SBD的结构图
从图2的结构图可以看出,同普通的GaN肖特基二极管相比,这种肖特基二极管具有以下优点:(1)提高电子迁移率,充分利用了二维电子气中电子的高迁移率和AlGaN/GaN异质结的自发极化,使得二极管在低掺杂或者不掺杂的情况下也能够产生电流,低掺杂进一步保证了高电子迁移率:(2)在AlGaN/GaN异质结横向肖特基二极管的基础上,利用异质结多沟道技术,使得纵向宽范围内电子浓度分布增加,使横向电子流驱动增强。通过以上两个方面可以有效的减小沟道电阻,提高肖特基极管截止频率。
2. 不同的氮化镓肖特基二极管直流特性比较
AlGaN/GaN异质结多沟道结构横向肖特基二极管,半导体材料部分是异质结多沟道,器件的结构相对复杂:为了能够对这种新结构肖特基二极管顺利仿真得出结果并与传统GaN基肖特基二极管作出对比,本文先对GaN肖特基二极管、AlGaN肖特基二极管和AlGaN/GaN单异质结肖特基二极管进行仿真。对不含有异质结的传统肖特基二极管仿真时,其半导体材料设定成单一材料GaN或AlGaN,之后再改成AlGaN/GaN异质结,这样仿真有个循序渐进的过程,能够方便的检验结果的正确性。
GaN、AlGaN肖特基二极管和AlGaN/GaN单异质结肖特基二极管都是横向结构(如图3所示),阳极是肖特基电极,金属的功函数设定成5.36eV,这是金属Pt的功函数。
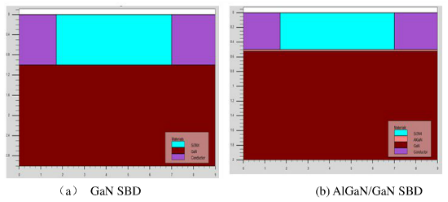
图3 仿真时采用的器件结构
2.1 正向IV特性
不同的半导体材料和掺杂浓度的肖特基二极管对应于不同的IV线。从正向静态特性中,可以清楚地看到二极管的开启电压和导通电阻的大小。开启电压指的是二极管开始导电时加的正向电压,而导通电阻则能从曲线的斜率看出,斜率越小电阻越大,反之电阻越小。
图4给出的是GaN SBD在不同掺杂浓度下的正向特性曲线,从图中可以看出,随着掺杂浓度的增加,电流变得更大,而二极管的正向开启电压始终保持在0.6V左右。
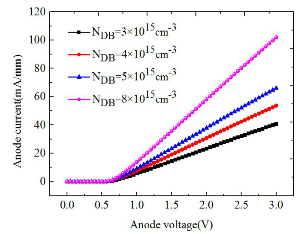
图4 不同掺杂浓度下GaN SBD正向特性曲线
图5给出的是AlGaN SE3D在不同掺杂浓度下的正向特性曲线(其中Al组分是0.3),从曲线的变化可以看出随着掺杂浓度的增加,电流变得更大,而二极管的正向开启电压始终保持在12V左右。
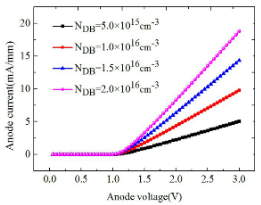
图5 不同掺杂浓度下AlGaN SBD的正向特性曲线
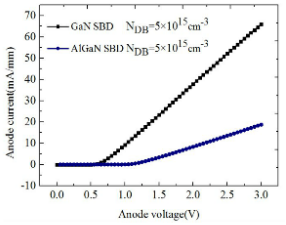
图6 AlGaN SBD和GaN SBD的正向Ⅳ特性的对比
图6给出的是同一掺杂浓度下,AlGaN SBD和GaN SBD的正向Ⅳ特性的对比图。根据曲线可以看出,AlGaN SBD的正向开启电压比 GaN SBD高出许多,而它的正向电流比GaN SBD的正向电流要小很多。经过思考后,分析原因如下:

表1 GaN和AlN的参数对比
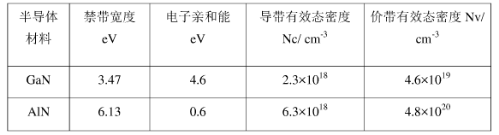
AlGaN材料的性质介于AlN和GaN之间,具体偏向可以由材料中的Al组分来决定。由此可知,AlGaN SBD中的Al组分会对二极管的正向特性造成很大的影响,改变Al组分会改变AlGaN的禁带宽度从而二极管的IV曲线。由于晶格匹配问题,AlGaN SBD中的Al组分一般为0到0.3。在AlGaN SBD中,选择Al组分分别为0.1,0.15,0.2和0.3进行仿真,得到AlGaN SBD的特性曲线如下图所示。
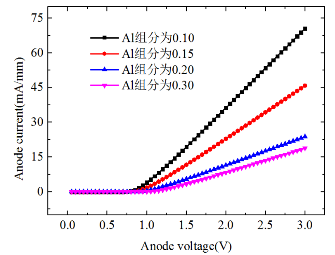
图7 不同Al组分的AlGaN SBD正向特性图线
从图7可以看出,随着A组分逐渐由0.3下降到0.1时,开启电压慢慢从1.1V下降到0.8V左右,正向电流不断增大,二极管的静态特性逐渐向GaN肖特基二极管靠近。仔细观察发现,AI组分由0.2增大到0.3时,二极管正向导通电流的大小变化不大,开启电压有一定改变。而在Al组分由0.2下降到0.1的过程中,肖特基二极管的正向电流有了很大的增幅,利用这一特性可以有效地调节AlGaN SBD的正向导通特性。根据前面的仿真结果可知,通过降低AlGaN SBD中的A组分,可以降低二极管的开启电压提高正向电流:通过一定的掺杂可以降低GaN SBD的导通电阻。接下来对AlGaN/GaN单异质结SBD进行仿真,选择GaN沟道层的掺杂浓度为NDB=5×1015cm-3,AlGaN势垒层的Al组为0.2,器件结构如图8所示,曲线如图9所示。
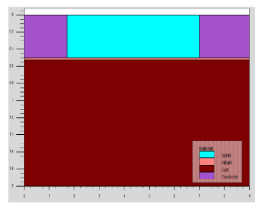
图8 AlGaN/GaN异质结SBD器件结构
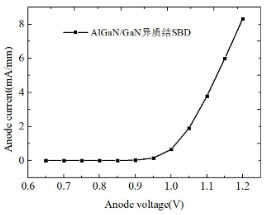
图9 Al组分为0.2时AlGaN/GaN异质结SBD的正向IV曲线
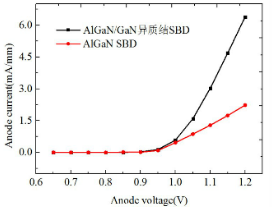
图10 AlGaN SBD和AlGaN/GaN异质结SBD的对比
图10是Al组分为0.2时,AlGaN SBD和AlGaN/GaN单异质结SBD的正向特性对比,AlGaN SBD和AGaN/GaN异质结SBD具有同样的肖特基势垒,从比较的情况中可以得出外延层沟道电阻对SBD静态特性的影响。依照曲线得出,AlGaN/GaN异质结SBD的正向导通电压也在1V左右,正向电流的大小和AlGaN SBD保持同一数量级,这是由金属和AlGaN形成的肖特基势垒决定的。同时可以看到,AlGaN/GaN单异质结SBD的Ⅳ曲线斜率比AlGaN SBD的IV曲线斜率要高,说明AlGaN/GaN单异质结SBD具有比较小的串联电阻。这是因为AlGaN/GaN单异质结SBD利用异质结二维电子气中电子的高迁移率,降低了沟道电阻,二极管正向电流上升的斜率更大。
2.2 反向击穿电压
前面主要对各种肖特基二极管的正向特性进行分析,接下来研究二极管的反向击穿电压,仿真过程中将反向电流出现急速升高的电压拐点定义成击穿电压。实验证实,在二极管的击穿过程中,掺杂浓度NDB对击穿电压有着很大的影响。原因在于随着掺杂浓度NDB的增加,二极管中的载流子浓度变得更高,在较大反向偏压下出现雪崩倍增时,碰撞电离产生的载流子数也越多,所以会导致击穿电压的减小。肖特基二极管可以类比于pn结二极管中的单边突变结二极管,它的击穿电压VBD可以通过下式进行计算:

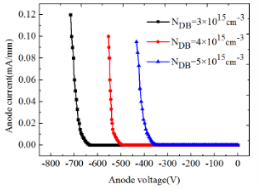
图11 不同掺杂浓度GaN的反向特性曲线
图12(a)-(c)给出的是掺杂浓度为1015cm-3的GaN SBD在反偏电压分别为-480V、-620V和-730V时器件内部电场的分布情况,图12(d)给出的是电场在器件上表面的分布情况。由图中得出,器件表面和阳极接近阴极的边缘位置的场强是最大的。随着反偏电压的增加,器件内部的电场也变得越大,但电场不是均匀增加的,在阳极下方的位置电场强度最大同时电场随着电压的增加也最为迅速,因而随着外加电压的增大,器件内部电场慢慢达到材料的临界击穿场强,由于雪崩倍增效应产生出大量电子二极管的反向电流急速增大,最终导致二极管击穿。
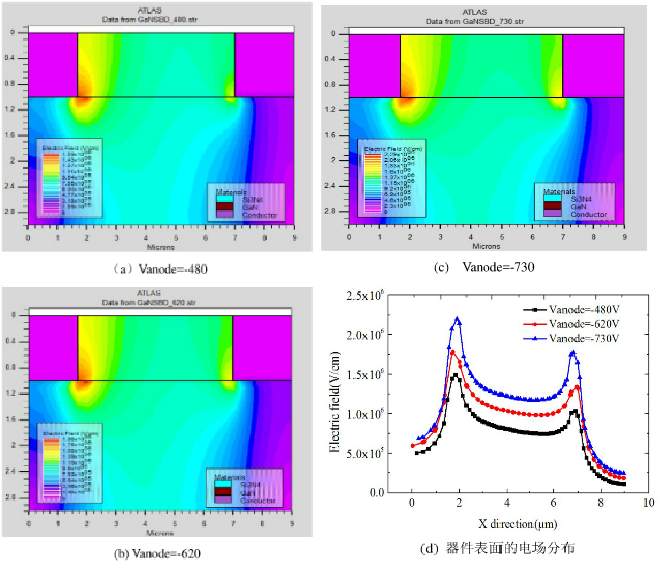
图12 GaNSBD反向击穿前后器件内部电场
图13给出的是AlGaN SBD和GaN SBD的击穿特性对比,其中AlGaN SBD的Al组分是0.25。从曲线对比可以得出,当掺杂浓度相同时,AlGaN SBD的击穿电压比GaN SBD的击穿电压高出许多,但是二极管击穿以后其反向电流增加的速度比GaN SBD要快一点。
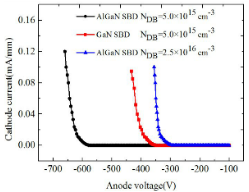
图13 AlGaN SBD和GaN SBD的反向击穿特性
根据之前两种肖特基二极管的仿真结果,在AlGaN/GaN单异质结肖特基二极管中,设定GaN沟道层的背景掺杂浓度NDB=5×1015cm-3以及AlGaN势垒层中A1组分为0.2是比较合理的。对于AlGaN/GaN单异质结肖特基二极管,它的反向击穿电压大小并不完全取决于掺杂浓度。在肖特基势垒高度不变的情况下,AlGaN/GaN单异质结的界面极化电荷也会对击穿电压带来一定的影响。AlGaN/ GaN单异质结肖特基极管和AlGaN肖特基二极管的击穿特性对比如下图所示。
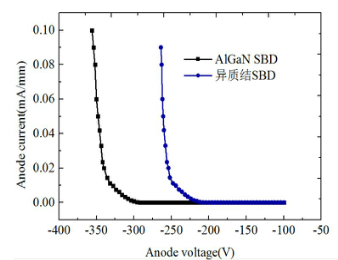
图14 单异质结SBD和AlGaN SBD击穿电压对比
从图14看出,和AlGaN SBD相比,AlGaN/GaN异质结SBD的击穿电压由300V左右下降到220V,可见加入AlGaN/GaN异质结后,肖特基二极管的反向击穿电压有了很大的降低。由此可知,AlGaN/GaN异质结的界面极化电荷对二极管反向击穿电压有很大的影响。异质结界面极化电荷能够改变二极管的击穿电压的原因是异质结的极化效应对器件的内部电场造成影响。图15给出的是AlGaN/GaN单异质结肖特基二极管和AlGaN肖特基二极管在没有外加电压时阳极下方纵向导带能量的对比。根据该图得出,引入AlGaN/GaN异质结后,势垒层中的导带能量迅速减小,形成二维电了气。
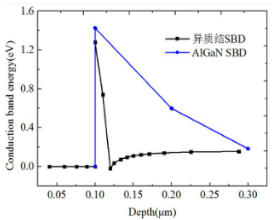
图15 阳极下方导带分布对比,阳极电压为0V
2.3 截止频率
肖特基二极管的截止颏率是由串联电阻和结电容共同决定的。在目前的工艺下,GaN基肖特基二极管的结电容通常在20fF,因此只要求出二极管的串联电阻,就可以计算得出二极管的截止频率。
根据热电子利用热电子发射理论,肖特基二极管的电流方程如下:

当外加偏压时,通常把串联电阻等价成一个独立的电阻,此时二极管等效成由一个理想二极管和串联电阻组成的电路,所以可以得到肖特基势垒上的电压降

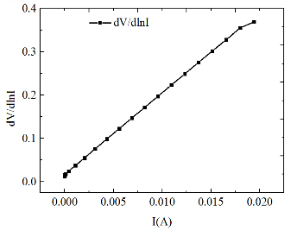
图16 GaN肖特基二极管的dV/dlnI和I的面线
图16是经过计算后GaN肖特基二极管的dV/dlnI和I的曲线,拟合得到GaN肖特基二极管的串联电阻是18.85Ω。知
 ,把串联电阻和结电容代入公式得到:
,把串联电阻和结电容代入公式得到:

3. 小结
本文主要是在Silvaco的Atlas平台对各种不同GaN基肖特基二极管进行仿真,对二极管的静态特寺性、反向击穿电压和截止频率进行研究。对GaN基肖特基二极管在不同掺杂情况下的静态特性分析比较,得到优化的二极管掺杂浓度。通过基于不同材料的肖特基二极管之间的对比,总结出影响二极管静态特性的重要参数,同时对异质结肖特基二极管作出初步的分析。对二极管的反向击穿特性进行研究,主要考虑不同掺杂浓度和不同器件结构对反向击穿电压的影响。计算传统结构GaN肖特基二极管和AlGaN/GaN单异质结肖特基二极管的截止频率,证实了异质结结构具有降低二极管串联电阻、提高截止频率的优势。
