因为衬底问题,氮化镓器件大多用蓝宝石衬底上的GaN外延层来做,而蓝宝石是绝缘体,因而氮化镓器件多为横向导电结构,SBD也不例外。尽管从大电流考虑电力电子器件还是以纵向导电结构为好,事实上也有人利用从厚外延片上剥离下来的200μm厚GaN独立薄片做过纵向导电的SBD,但厚外延片的缺陷密度太高,做出来的器件虽然电流较大,但反向漏电流也很大,阻断电压与GaN应该达到的水平相距甚远,因而目前仍主要采用横向导电设计,或台面造型设计。大电流氮化镓肖特基二极管(SBD)只能寄希望于GaN体单晶制备技术的成功。
横向导电氮化镓肖特基二极管(SBD)设计中值得推荐的是利用了2DEG的高导电性的AGaN/GaN异质结SBD。这种器件的做法其实跟耗尽型HEMT的做法相似,所不同的只是把HEMT的源极和漏极合并为一个电极,同时把HEMT的栅极做成肖特基势垒接触并扩大作为另一个电极。图1是韩国首尔大学的Lee等2005年发表的一个耐压930V的 AlGAN/GaN异质结SBD的结构示意图。该器件的另一个结构特点是为了提高阻断电压而在 AIGAN上再生长了薄薄一层未掺杂GaN,并在其上设置了一个环绕肖特基接触的浮电位金属环(FMR)。在各种终端技术中,FMR比较适合SBD,因为它可以同肖特基接触同时制作,并且能在反偏状态下帮助肖特基接触附近的表面空间电荷区扩展,有效防止表面电场集中。
氮化镓肖特基二极管(SBD)的基本制造工艺及相关参数如下:
1) 直接选用制造高压HEMT用的蓝宝石衬底 AIGAN/GaN外延片,各层厚度如图1所示。霍尔测试验明其薄层载流子密度为7.8×1012/cm,电子迁移率为1530cm2/V·s。
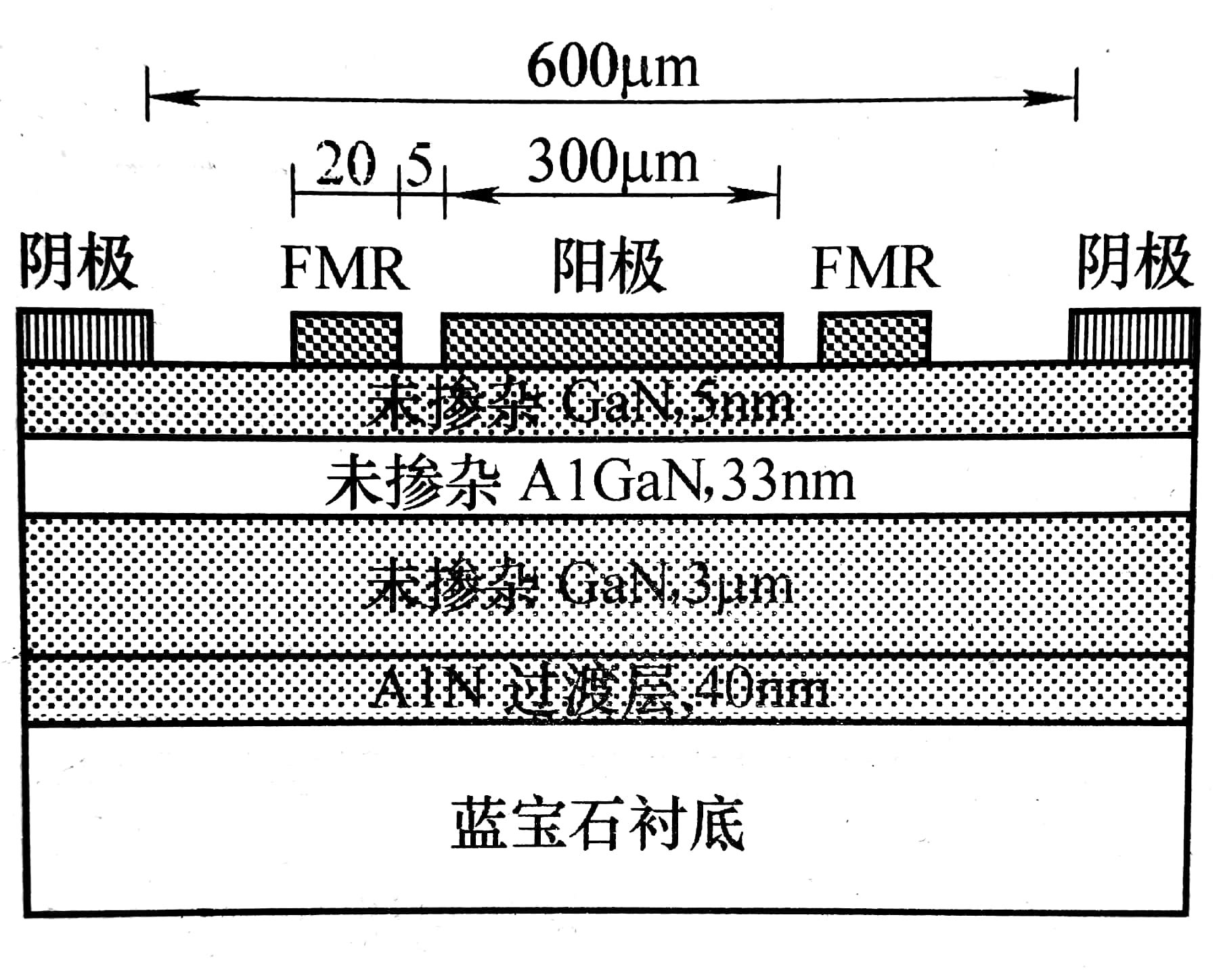
图1 带FMR的 AlGAN/Gan SBD结构
2) 用剥离(lift-off)法制作欧姆电极。蒸电极之前先用1:1的盐酸稀释液去除接触面的自然氧化物,然后用电子束蒸发顺序淀积Ti/Al/Ni/Au,厚度顺次为20/80/20/100nm,然后用快速退火法在880℃的流动氮气氛中退火30s。
3) 继续用剥离法制作肖特基电极和FMR,金属的电子束蒸发顺序为Pt/Mo/Ti/Au,厚度顺次为5/20/20/270nm。因为Pt的功函数高达5.65eV,用它做肖特基势垒接触容易获得较高的反向击穿电压和较低的反向漏电流;Mo是高熔点金属,用它可提高接触的高温稳定性。该器件试验样管圆形肖特基势垒接触的直径为300μm,肖特基接触与FMR和欧姆接触的最短距离分别为5μm和150μm,FMR的宽度为20μm。
测试结果表明,该器件在没有FMR时的击穿电压只有578V,而设置了3个FMR之后的击穿电压提高到930V,通态比电阻只有0.38Ω·cm2。
