氮化镓材料同时具有相对比较大的电子跃迁阈值电场(250KV/cm)和相对比较高击穿电场(3MV/cm), 因此氮化镓耿氏器件可以在相对比较高的偏压下工作,同样也可产生相对比较高的输出功率。氮化镓耿氏器件可望解决传统转移电子器件在功率输出偏低方面的问题,其最大输出功率可作如下估算:
在关于畴渡越假设的模型下,耿氏二极管器件有源区的长度L与器件振荡频率f的关系为: f=vsat / L,其中vsat为电子饱和漂移速度。由于半导体材料上的外加电场不能无限地增加,必须小于其击穿电场EB,因此器件上的最大偏压VD为:

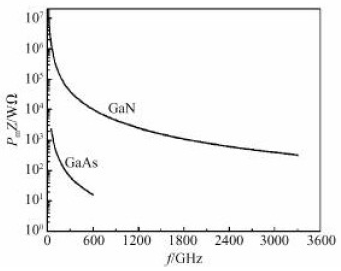
图1 氮化镓和砷化镓两种材料的转移电子器件PmZ与频率f的关系曲线
2. 氮化镓耿氏二极管掺杂浓度计算
对于耿氏器件而言,在一定偏压下能否形成稳定的耿氏振荡,主要取决于其掺杂浓度浓度N与其相应的转移电子器件有源区长度L的乘积值以及临界掺杂浓度Nerit两个方面。
1)在畴渡越模型下,因为畴的生长需要时间,在一定的掺杂浓度下,一个稳定畴的形成就需要器件具有一个最小的有源区长度。氮化镓耿氏器件要形成稳定的耿氏振荡,器件中畴的形成时间3τ(τ为介电弛豫时间)就应当小于畴经过器件有源区的渡越时间,由此可估算这个有源区的最小长度。
具有微分负阻特性的半导体中畴的形成过程如下:现在设定氮化镓耿氏器件的电阻为R,电容为C,则有

DΔQ=ΔQ(0) exp(-t/τ) (8)
其中ΔQ(0)表示在t=0时刻空间电荷中电荷量大小,τ的大小表征了空间电荷生长的快慢,而高场畴(偶极畴)实际形成的时间约为3τ。对于转移电子器件,高场畴在体内渡越的时间一定要大于等于其形成的时间,否则就不能形成稳定的耿氏振荡。因此,需满足t≥3τ,即:

2)耿氏二极管(转移电子器件)在畴渡越时间模式下产生的振荡频率f 约为:


表1 氮化镓和砷化镓材料的参数(NL)0和Ncrit